
CPU芯片里面几千万的晶体管是怎么实现的? |
|
那个… 有不少示意图, 流量党酌情进{:6_165:}
要想造个芯片, 首先, 你得画出来一个长这样的玩意儿给Foundry (外包的晶圆制造公司)(此处担心有版权问题… 就不放全电路图了… 大家看看就好, 望理解! ) 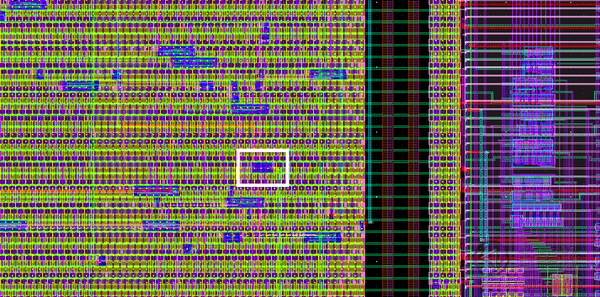
👃🗼🫑™🦕 再放大 
🧑🚀🩲💿🥰🤌 cool! 我们终于看到一个门电路啦! 这是一个NAND Gate(与非门), 大概是这样: 
👂🎠🍞📳🐻 A, B 是输入, Y是输出。其中蓝色的是金属1层, 绿色是金属2层,,紫色是金属3层,,粉色是金属4层... 那晶体管(更正, 题主的"晶体管" 自199X年以后已经主要是 MOSFET, 即场效应管了 ) 呢? 仔细看图, 看到里面那些白色的点吗? 那是衬底, 还有一些绿色的边框? 那些是Active Layer (也即掺杂层.) 🖕⛵🥛🈴🐶 然后Foundry是怎么做的呢? 大体上分为以下几步: 首先搞到一块圆圆的硅晶圆, (就是一大块晶体硅, 打磨的很光滑, 一般是圆的) 🤟🛑🥭🅿🐻 此处重新排版, 图片按照生产步骤排列. 但是步骤总结单独写出。 1. 湿洗 (用各种试剂保持硅晶圆表面没有杂质) 2. 光刻 (用紫外线透过蒙版照射硅晶圆, 被照到的地方就会容易被洗掉, 没被照到的地方就保持原样. 于是就可以在硅晶圆上面刻出想要的图案. 注意, 此时还没有加入杂质, 依然是一个硅晶圆. ) 👨🦱👚🖲😄🤙 3. 离子注入 (在硅晶圆不同的位置加入不同的杂质, 不同杂质根据浓度/位置的不同就组成了场效应管.) 4.1干蚀刻 (之前用光刻出来的形状有许多其实不是我们需要的,而是为了离子注入而蚀刻的. 现在就要用等离子体把他们洗掉, 或者是一些第一步光刻先不需要刻出来的结构, 这一步进行蚀刻). 👴🥼✒😥👂 4.2湿蚀刻 (进一步洗掉, 但是用的是试剂, 所以叫湿蚀刻). 以上步骤完成后, 场效应管就已经被做出来啦~ 但是以上步骤一般都不止做一次, 很可能需要反反复复的做, 以达到要求. 5.等离子冲洗 (用较弱的等离子束轰击整个芯片)🧒🧥🖨🥰🧠 6 热处理, 其中又分为: 6.1 快速热退火 (就是瞬间把整个片子通过大功率灯啥的照到1200摄氏度以上, 然后慢慢地冷却下来, 为了使得注入的离子能更好的被启动以及热氧化) 🧓🧻🤬👍 6.2 退火 6.3 热氧化 (制造出二氧化硅, 也即场效应管的栅极(gate) ) 7 化学气相淀积(CVD), 进一步精细处理表面的各种物质🧑🎤👓🔋🙂💪 8 物理气相淀积 (PVD), 类似, 而且可以给敏感部件加coating 9 分子束外延 (MBE) 如果需要长单晶的话就需要这个.. 💪🌞🫑🚷🐞 10 电镀处理 11 化学/机械 表面处理 然后芯片就差不多了, 接下来还要:🧑⚕️👠⚒🤖✊ 12 晶圆测试 13 晶圆打磨就可以出厂封装了.我们来一步步看: 
1上面是氧化层, 下面是衬底(硅) -- 湿洗 
2 一般来说, 先对整个衬底注入少量(10^10 ~ 10^13 / cm^3) 的P型物质(最外层少一个电子), 作为衬底 -- 离子注入 👵👒🦯🙃🙏 
3先加入Photo-resist, 保护住不想被蚀刻的地方 -- 光刻 
4.上掩膜! (就是那个标注Cr的地方. 中间空的表示没有遮盖, 黑的表示遮住了.) -- 光刻 👏🎢🫑‼🐢 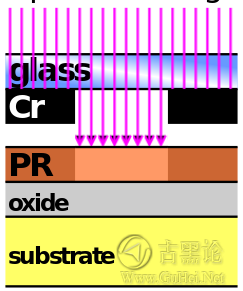
5 紫外线照上去... 下面被照得那一块就被反应了 -- 光刻 🧑🍳🩴⚒😅🦷 
6.撤去掩膜. -- 光刻 
7 把暴露出来的氧化层洗掉, 露出硅层(就可以注入离子了) -- 光刻 👁🏝🥭♊🐟 
8 把保护层撤去. 这样就得到了一个准备注入的硅片. 这一步会反复在硅片上进行(几十次甚至上百次). -- 光刻 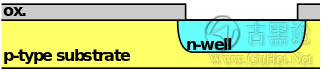
9 然后光刻完毕后, 往里面狠狠地插入一块少量(10^14 ~ 10^16 /cm^3) 注入的N型物质就做成了一个N-well (N-井) -- 离子注入 👦🧥🛏🥱👀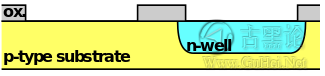
10 用干蚀刻把需要P-well的地方也蚀刻出来. 也可以再次使用光刻刻出来. -- 干蚀刻 🦷🏠🥭⁉🦄 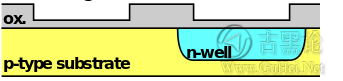
11 上图将P-型半导体上部再次氧化出一层薄薄的二氧化硅. -- 热处理 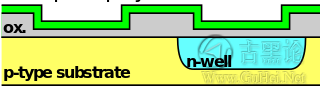
12 用分子束外延处理长出的一层多晶硅, 该层可导电 -- 分子束外延 👩🧦🪟🥰✋ 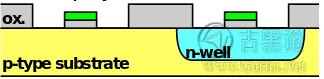
13 进一步的蚀刻, 做出精细的结构. (在退火以及部分CVD) -- 重复3-8光刻 + 湿蚀刻 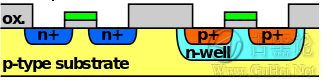
14 再次狠狠地插入大量(10^18 ~ 10^20 / cm^3) 注入的P/N型物质, 此时注意MOSFET已经基本成型. -- 离子注入 🤳⛴🥩🆒🐻 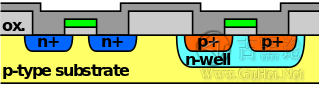
15 用气相积淀 形成的氮化物层 -- 化学气相积淀 🖕🍚🈴🦋 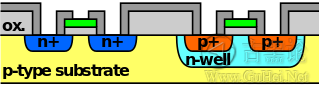
16 将氮化物蚀刻出沟道 -- 光刻 + 湿蚀刻 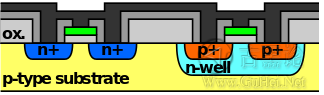
17 物理气相积淀长出 金属层 -- 物理气相积淀 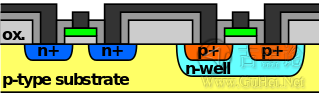
18 将多余金属层蚀刻. 光刻 + 湿蚀刻 👂🍍☯🦠 重复 17-18 长出每个金属层 哦对了... 最开始那个芯片, 大小大约是1.5mm x 0.8mm ~~ 找到一本关于光刻的书, 更新一下, 书名: << IC Fabrication Technology >> By BOSE👨🦱📡😡🖕 细说一下光刻: 小于头发丝直径的操作会很困难, 所以光刻(比如说100nm)是怎么做的呢? 比如说我们要做一个100nm的门电路(90nm technology), 那么实际上是这样的: 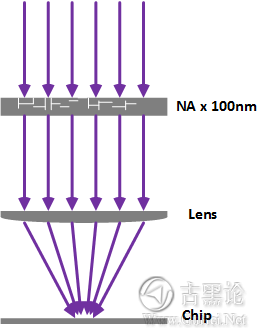
🙏🪐🍍🉑🐙 这层掩膜是第一层, 大概是10倍左右的Die Size 有两种方法制作: Emulsion Mask 和 Metal Mask Emulsion Mask: 
这货分辨率可以达到 2000line / mm (其实挺差劲的... 所以sub-micron ,也即um级别以下的 VLSI不用... ) 制作方法: 首先: 需要在Rubylith (不会翻译...) 上面刻出一个比想要的掩膜大个20倍的形状 (大概是真正制作尺寸的200倍), 这个形状就可以用激光什么的刻出来, 只需要微米级别的刻度. 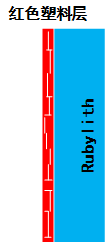
然后: 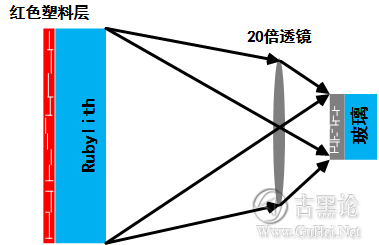
给!它!照!相! , 相片就是Emulsion Mask! 如果要拍的"照片"太大, 也有分区域照的方法. Metal Mask: 
制作过程: 1. 先做一个Emulsion Mask, 然后用Emulsion Mask以及我之前提到的17-18步做Metal Mask! 瞬间有种Recursion的感觉有木有!!! 2. Electron beam: 大概长这样 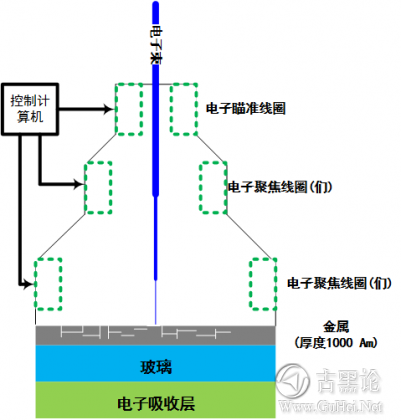
制作的时候移动的是底下那层. 电子束不移动. 就像打印机一样把底下打一遍. 好处是精度特别高, 目前大多数高精度的(<100nm技术)都用这个掩膜. 坏处是太慢... 💪🏝🌰🅱🦠 做好掩膜后: Feature Size = k*lamda / NAk 一般是0.4, 跟制作过程有关; lamda是所用光的波长; NA是从芯片看上去, 放大镜的倍率. 以目前的技术水平, 这个公式已经变了, 因为随着Feature Size减小, 透镜的厚度也是一个问题了。 Feature Size = k * lamda / NA^2 恩.. 所以其实掩膜可以做的比芯片大一些. 至于具体制作方法, 一般是用高精度计算机探针 + 激光直接刻板. Photomask(掩膜) 的材料选择一般也比硅晶片更加灵活, 可以采用很容易被激光汽化的材料进行制作. 浸没式光刻 👴👚🎺😒🦷 这个光刻的方法绝壁是个黑科技一般的点! 直接把Lamda缩小了一个量级, With no extra cost! 你们说吼不吼啊! Food for Thought: Wikipedia上面关于掩膜的版面给出了这样一幅图, 假设用这样的掩膜最后做出来会是什么形状呢? 
于是还没有人理Food for thought... 大部分附图, 来自AnandTech | An Introduction to Semiconductor Physics, Technology, and Industry , 附图的步骤在每幅图的下面标注, 一共18步. 如有错误欢迎指教! 最终成型大概长这样: 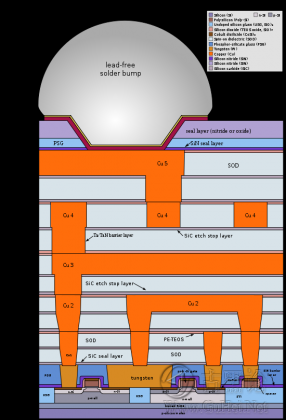
其中, 步骤1-15 属于 前端处理 (FEOL), 也即如何做出场效应管 👨🚒👑🖲😴👄 步骤16-18 (加上许许多多的重复) 属于后端处理 (BEOL) , 后端处理主要是用来布线. 最开始那个大芯片里面能看到的基本都是布线! 一般一个高度集中的芯片上几乎看不见底层的硅片, 都会被布线遮挡住. 版权归原网站 (ANAND TECH) 以及原作者所有, 仅供示意参考 SOI (Silicon-on-Insulator) 技术: 传统CMOS技术的缺陷在于: 衬底的厚度会影响片上的寄生电容, 间接导致芯片的性能下降. SOI技术主要是将源极/漏极和硅片衬底分开, 以达到(部分)消除寄生电容的目的. 传统: 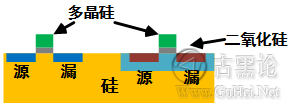
SOl: 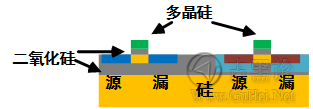
👎🌦🍇🅾🐒 制作方法主要有以下几种(主要在于制作硅-二氧化硅-硅的结构, 之后的步骤跟传统工艺基本一致.) 1. 高温氧化退火: 
在硅表面离子注入一层氧离子层 
等氧离子渗入硅层, 形成富氧层 
高温退火 👂🌞🥑🐝 
成型. 或者是2. Wafer Bonding(用两块! )不是要做夹心饼干一样的结构吗? 爷不差钱! 来两块! 
来两块! 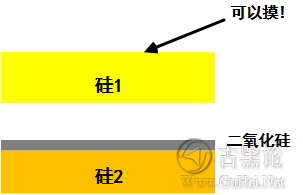
对硅2进行表面氧化 
对硅2进行氢离子注入 🖐🚈🥩🔞🕊 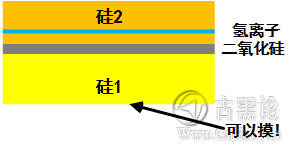
翻面 
将氢离子层处理成气泡层将氢离子层处理成气泡层 
切割掉多余部分 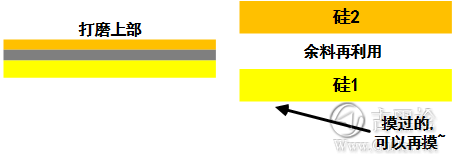
成型! + 再利用成型! + 再利用 (原谅我直接视频截图了, 3D图 Visio真心画不出啊!!!) 🤌🪐🍊✡🐮 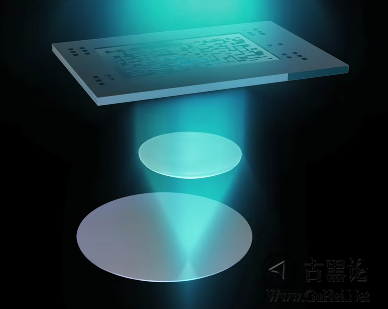
光刻光刻 
离子注入 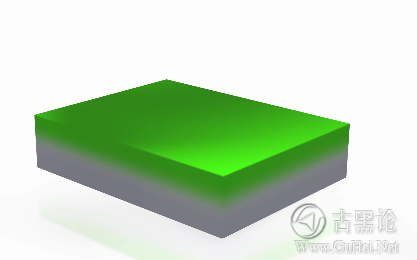
微观图长这样 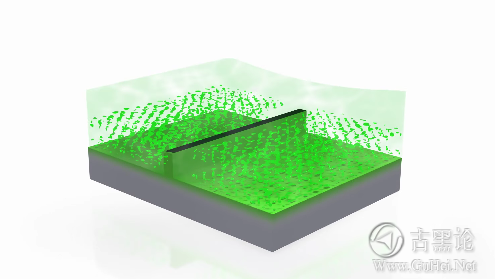
再次光刻+蚀刻 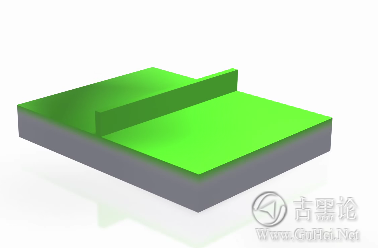
撤去保护, 中间那个就是Fin 🙌🚠🦀♑🪰 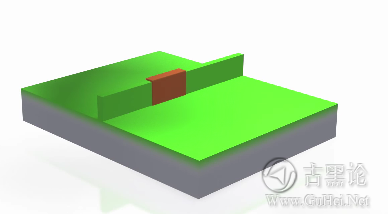
门部位的多晶硅/高K介质生长 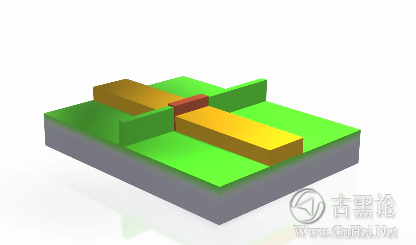
门部位的氧化层生长 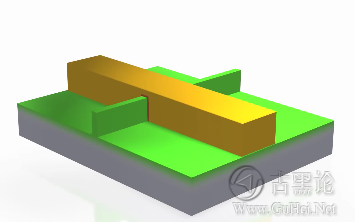
长成这样 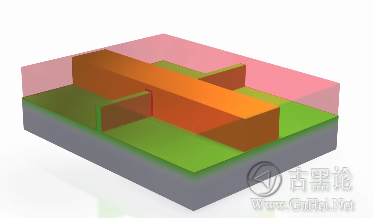
源极 漏极制作(光刻+ 离子注入) 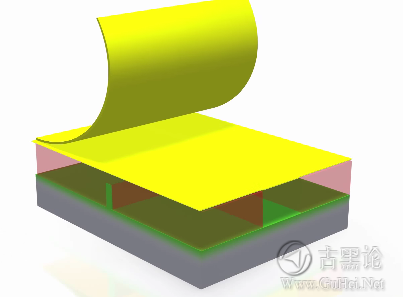
初层金属/多晶硅贴片 👈🛑🍞🈚🐅 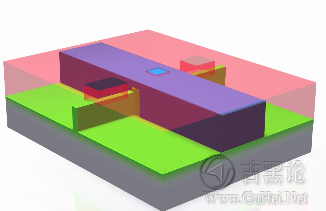
蚀刻+成型蚀刻+成型 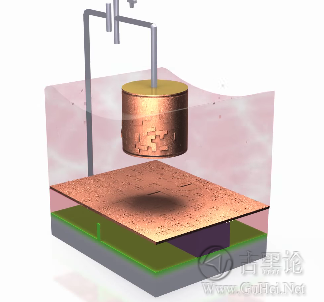
物理气相积淀长出表面金属层(因为是三维结构, 所有连线要在上部连出) 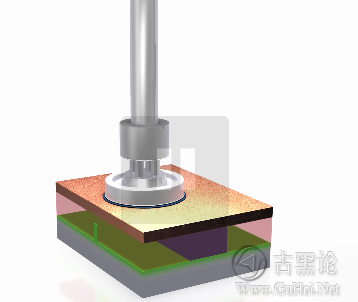
机械打磨(对! 不打磨会导致金属层厚度不一致) 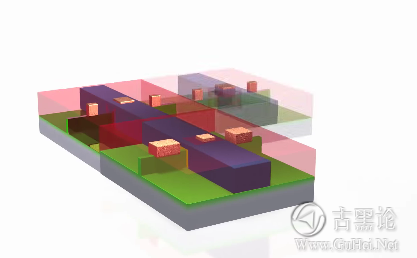
成型! 成型! 
连线 就大概这样子..
帖子热度 1.7万 ℃
哇!小执念被楼主看上了奖励 2 个 金币.
|
|
|
|
在逐字逐句地看完这个帖子以后,我的心久久不能平静,震撼啊!为什么会有如此好的帖子?!我纵横网络bbs多年,自以为再也不会有任何帖子能打动我,没想到今天看到了如此精妙绝伦的这样一篇帖子。
|
|
第一次评论,
好紧张啊, 🧑🎤👙📬🙂👃 该怎么说啊, 打多少字才显的有文采啊, 这样说好不好啊, 👍🚤🍼❌🐶 会不会成热贴啊, 我写的这么好会不会太招遥, 写的这么深奥别人会不会看不懂啊, 👴🎒🛏🤬🤟 怎样才能写出我博士后的水平呢, 半年写了这么多会不会太快啊, 好激动啊。#y424:#y424: |
 「古黑浩劫」
「古黑浩劫」
 变色卡
变色卡 古黑论管理员,在论坛上有什么问题都可以找他。
古黑论管理员,在论坛上有什么问题都可以找他。